반응 이온 식각
Reactive-ion etching이 글은 검증을 위해 인용구가 추가로 필요하다. – 뉴스· ·· · JSTOR(2021년 9월) (이 템플릿 |
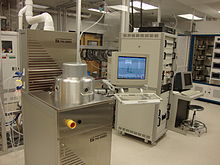
반응형 이온 식각(RIE)은 미세조립에 사용되는 식각 기술이다. RIE는 습식 식각과는 다른 특성을 가진 건식 식각의 일종이다. RIE는 화학적으로 반응하는 플라즈마를 사용하여 웨이퍼에 침전된 물질을 제거한다. 플라스마는 전자기장에 의해 저압(진공)에서 생성된다. 플라즈마에서 나오는 고에너지 이온은 웨이퍼 표면을 공격하여 반응한다.
장비
일반적인 (병렬 플레이트) RIE 시스템은 원통형 진공 챔버로 구성되며, 웨이퍼 플래터가 챔버 하단에 위치한다. 웨이퍼 플래터는 챔버의 나머지 부분으로부터 전기적으로 격리된다. 가스는 챔버 상단의 작은 Inlet을 통해 들어가고, 하단을 통해 진공 펌프 시스템으로 빠져나간다. 사용되는 가스의 종류와 양은 에치 공정에 따라 다르다. 예를 들어, 6불화 황은 실리콘 에칭에 일반적으로 사용된다. 가스 압력은 일반적으로 가스 유량을 조정하거나 배기 오리피스를 조정하여 몇 밀리터리와 몇 백 밀리터 사이의 범위에서 유지된다.
유도결합플라즈마(ICP) RIE를 포함한 다른 유형의 RIE 시스템이 존재한다. 이 유형의 시스템에서 플라즈마는 무선 주파수(RF) 동력 자기장으로 생성된다. 에치 프로파일이 더 등방성적인 경향이 있지만 매우 높은 혈장 밀도를 달성할 수 있다.
병렬 플레이트와 유도 결합 플라즈마 RIE의 조합이 가능하다. 이 시스템에서는 ICP를 이온의 고밀도 공급원으로 채용하여 에치율을 높이는 한편, 기질(실리콘 웨이퍼)에 별도의 RF 바이어스를 적용하여 기질 근처에 지향성 전기장을 생성하여 보다 비등방성 에치 프로파일을 달성한다.[1]
운영방법
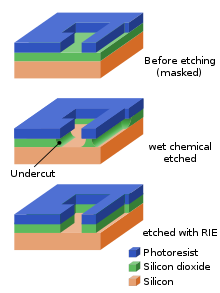
플라즈마는 웨이퍼 플래터에 강한 RF(무선 주파수) 전자기장을 적용하여 시스템에서 시작된다. 필드는 일반적으로 몇 백 와트로 적용되는 13.56 MHz 주파수로 설정된다. 진동하는 전기장은 가스 분자를 전자로부터 떼어내어 플라즈마를 만들어냄으로써 이온화시킨다.
전자의 각 사이클에서 전자는 챔버에서 전기적으로 위아래로 가속되며, 때로는 챔버의 상부 벽과 웨이퍼 플래터 모두에 부딪친다. 동시에, 훨씬 더 큰 이온은 RF 전기장에 반응하여 상대적으로 적게 움직인다. 전자가 챔버 벽으로 흡수될 때 그것들은 단지 땅으로 공급되고 시스템의 전자 상태를 바꾸지 않는다. 그러나 웨이퍼 플래터에 축적된 전자는 플래터의 DC 절연으로 인해 플래터의 전하를 증가시킨다. 이 충전 증가는 플래터에 큰 음전압을 발생시키며, 일반적으로는 수백 볼트 정도가 된다. 플라즈마 자체는 자유 전자에 비해 양 이온의 농도가 높아 약간 양전하를 발생시킨다.
전압 차이가 크기 때문에 양의 이온은 웨이퍼 플래터 쪽으로 표류하는 경향이 있으며, 여기서 에칭할 샘플과 충돌한다. 이온들은 샘플 표면의 물질과 화학적으로 반응하지만, 그들의 운동에너지의 일부를 전달함으로써 일부 물질을 녹여낼 수도 있다. 반응성 이온의 대부분 수직 전달 때문에 반응성 이온 식각은 매우 비등방성 식각 프로파일을 생성할 수 있으며, 습식 화학 식각의 전형적 등방성 프로필과 대조된다.
RIE 시스템의 에치 조건은 압력, 가스 흐름 및 RF 전력과 같은 많은 공정 매개변수에 크게 의존한다. RIE의 수정된 버전은 깊은 기능을 발굴하는 데 사용되는 딥 리액티브 이온 식각이다.
참고 항목
참조
- ^ "Large-area multicrystalline silicon solar cell fabrication using reactive ion etching (RIE)". Solar Energy Materials and Solar Cells. 95 (1): 2–6. 2011-01-01. doi:10.1016/j.solmat.2010.03.029. ISSN 0927-0248.



