고순도 유전체
High-κ dielectric고분자 유전체란 이산화규소에 비해 유전율(δ, kappa)이 높은 물질을 말한다.고밀도 유전체는 반도체 제조 공정에서 사용되며, 일반적으로 이산화규소 게이트 유전체 또는 소자의 다른 유전체층을 대체하기 위해 사용됩니다.고분자 게이트 유전체의 구현은 마이크로 전자 부품의 추가적인 소형화를 가능하게 하기 위해 개발된 여러 전략 중 하나입니다. 이 전략은 일반적으로 무어의 법칙 확장이라고 합니다.때때로 이러한 재료는 "하이 카파" 대신 "하이 카"(high-kay로 발음)라고 불립니다.
고밀도 재료의 필요성
이산화규소(SiO2)는 수십 년 동안 게이트 산화물로 사용되어 왔습니다.금속산화물반도체전계효과트랜지스터(MOSFET)의 크기가 작아짐에 따라 이산화실리콘 게이트 유전체의 두께가 꾸준히 감소하여 게이트 캐패시턴스(단위면적당)를 증가시켜 전류(디바이스 폭당)를 구동함으로써 디바이스 성능을 높일 수 있다.두께가 2nm 이하가 되면 터널링에 의한 누설전류가 급격히 증가하여 소비전력이 높고 디바이스의 신뢰성이 저하됩니다.이산화실리콘 게이트 유전체를 고방사성 물질로 교체하면 관련된 누출 효과 없이 게이트 캐패시턴스를 늘릴 수 있습니다.
제1원칙
MOSFET의 게이트 산화물은 병렬 플레이트 캐패시터로 모델링할 수 있습니다.Si 기판과 게이트로부터의 양자역학 및 고갈 효과를 무시하면 이 평행판 캐패시터 C는 다음과 같이 주어진다.
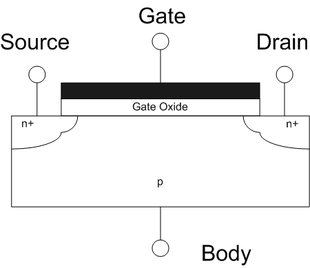
어디에
- A는 캐패시터 영역입니다.
- θ는 물질의 상대 유전율(이산화규소의 경우 3.9)이다.
- θ는0 여유 공간의 유전율이다.
- t는 캐패시터 산화물 절연체의 두께입니다.
리크 제한은 t의 저감을 더욱 억제하기 때문에 게이트 캐패시턴스를 증가시키는 대체 방법은 이산화실리콘을 고γ 재료로 치환함으로써 변경된다.이러한 시나리오에서는 게이트 유전체 신뢰성을 향상시킬 뿐만 아니라 구조를 통과하는 누설 전류를 줄일 수 있는 두꺼운 게이트 산화층을 사용할 수 있다.
게이트 캐패시턴스가 드라이브 전류에 미치는 영향
MOSFET의 드레인 전류D I은 다음과 같이 쓸 수 있습니다(점차적인 채널 근사 사용).
어디에
- W는 트랜지스터 채널의 폭입니다.
- L은 채널 길이입니다.
- μ는 채널캐리어 모빌리티입니다(여기서는 일정합니다).
- C는inv 기본 채널이 반전 상태일 때 게이트 유전체와 관련된 용량 밀도입니다.
- V는G 트랜지스터 게이트에 인가되는 전압입니다.
- V는th 임계값 전압입니다.
V - V라는th 용어는G 너무 큰G V는 산화물에 바람직하지 않은 높은 전장을 생성하기 때문에 신뢰성과 상온 작동 제약으로 인해 범위가 제한됩니다.또한 산화물 누출의 증가(즉, 높은 유전체를 사용할 수 없다고 가정)와 역치 이하의 전도성으로 인한 누출 전류가 대기 전력 소비를 허용할 수 없는 수준으로 증가시키기 때문에 V를th 약 200mV 이하로 쉽게 줄일 수 없습니다(임계값을 200mV로 제한하는 산업 로드맵 [1]및 로이 등 참조).따라서 이 단순화된 요인 목록에 따르면 I가 증가하면D,sat 채널 길이 감소 또는 게이트 유전체 캐패시턴스 증가가 필요합니다.
소재 및 고려사항
이산화실리콘 게이트 유전체를 다른 재료로 교체하면 제조 공정이 복잡해집니다.이산화실리콘은 기초 실리콘을 산화시켜 균일하고 등각 산화물과 높은 계면 품질을 보장함으로써 형성될 수 있습니다.그 결과, 제조 공정에 용이하게 통합할 수 있는 유전율이 높은 재료를 찾는 데 개발 노력이 집중되어 왔습니다.기타 주요 고려사항으로는 실리콘에 대한 대역 정렬(누설 전류를 변경할 수 있음), 필름 형태학, 열 안정성, 채널 내 전하 캐리어의 높은 이동성 유지 및 필름/인터페이스의 전기적 결함 최소화 등이 있습니다.상당한 관심을 받아온 물질로는 규산 하프늄, 규산 지르코늄, 이산화 하프늄 및 이산화 지르코늄이 있으며, 일반적으로 원자층 증착을 통해 축적된다.
고전압 유전체의 결함 상태가 전기적 특성에 영향을 미칠 수 있을 것으로 예상됩니다.결함상태는 예를 들어 열자극전류, 열자극전류분광법 또는 비탄성전자터널링분광법([3][4]IETs)을 사용하여 측정할 수 있다.
산업에서의 사용
산업에서는 1990년대부터 옥시질화 게이트 유전체를 사용해 왔으며, 이 유전체에는 소량의 질소가 주입되어 있습니다.질화물 함량은 유전율을 미묘하게 높이고 게이트 유전체를 통한 도판트 확산에 대한 저항성과 같은 다른 이점을 제공하는 것으로 생각됩니다.
2000년에는 Gurtej Singh Sandhu와 Trung T.마이크론테크놀로지의 도안은 D램 메모리 소자용 원자층 증착 고밀도 필름 개발을 시작했다.이를 통해 90nm 노드 [5][6]D램을 시작으로 반도체 메모리의 비용 효율적인 구현을 추진할 수 있었습니다.
2007년 초 인텔은 45나노미터 테크놀로지에 기반한 컴포넌트용 메탈릭 게이트와 함께 하프늄 기반의 고전압 유전체를 도입하여 Penryn이라는 [7][8]코드명으로 2007년 시리즈 프로세서로 출하했습니다.동시에 IBM은 2008년에 일부 제품에 대해서도 하프늄 기반의 고순도 재료로 전환할 계획을 발표했습니다.식별되지 않았지만, 이러한 용도에 사용되는 가장 가능성이 높은 유전체는 질화 하프늄 규산염(HfSiON)의 일종입니다.HfO2 및 HfSiO는 도판트 활성화 아닐 중에 결정화되기 쉽다.NEC전자는 또한 55nm UltimateLowPower [9]기술에 HfSiON 유전체를 사용한다고 발표했습니다.단, HfSiON조차도 트랩 관련 누설 전류에 취약하며, 이는 디바이스의 라이프 타임에 걸쳐 스트레스에 따라 증가하는 경향이 있습니다.이러한 누출 영향은 하프늄 농도가 증가할수록 더 심각해진다.그러나 하프늄이 미래의 고농도 유전체의 실질적인 기초가 될 것이라는 보장은 없다.2006년 ITRS 로드맵에서는 2010년까지 업계에서 고밀도 재료의 도입이 일반화될 것으로 예측하고 있습니다.
참고 항목
레퍼런스
- ^ "Process Integration, Devices, and Structures" (PDF). International Technology Roadmap for Semiconductors: 2006 Update. Archived from the original (PDF) on 2007-09-27.
- ^ Kaushik Roy, Kiat Seng Yeo (2004). Low Voltage, Low Power VLSI Subsystems. McGraw-Hill Professional. Fig. 2.1, p. 44. ISBN 978-0-07-143786-8.
- ^ Lau, W. S.; Zhong, L.; Lee, Allen; See, C. H.; Han, Taejoon; Sandler, N. P.; Chong, T. C. (1997). "Detection of defect states responsible for leakage current in ultrathin tantalum pentoxide (Ta[sub 2]O[sub 5]) films by zero-bias thermally stimulated current spectroscopy". Applied Physics Letters. 71 (4): 500. Bibcode:1997ApPhL..71..500L. doi:10.1063/1.119590.
- ^ Lau, W. S.; Wong, K. F.; Han, Taejoon; Sandler, Nathan P. (2006). "Application of zero-temperature-gradient zero-bias thermally stimulated current spectroscopy to ultrathin high-dielectric-constant insulator film characterization". Applied Physics Letters. 88 (17): 172906. Bibcode:2006ApPhL..88q2906L. doi:10.1063/1.2199590.
- ^ "IEEE Andrew S. Grove Award Recipients". IEEE Andrew S. Grove Award. Institute of Electrical and Electronics Engineers. Retrieved 4 July 2019.
- ^ Sandhu, Gurtej; Doan, Trung T. (22 August 2001). "Atomic layer doping apparatus and method". Google Patents. Retrieved 5 July 2019.
- ^ "Intel 45nm High-k Silicon Technology Page". Intel.com. Retrieved 2011-11-08.
- ^ "IEEE Spectrum: The High-k Solution". Archived from the original on 2007-10-26. Retrieved 2007-10-25.
- ^ "UltimateLowPower Technology Advanced Process Technology Technology NEC Electronics". Necel.com. Archived from the original on 2010-02-19. Retrieved 2011-11-08.
추가 정보
- 응용물리학 저널에 실린 Wilk 등의 논문을 검토한다.
- Houssa, M. (Ed.) (2003) High-k 유전 물리학 연구소 ISBN 0-7503-0906-7 CRC 온라인 프레스
- Huff, H.R., Gilmer, D.C. (Ed.) (2005) 고유전율 재료: VLSI MOSFET 응용 Springer ISBN 3-540-21081-4
- Demkov, A.A, Navrottsky, A., (Ed.) (2005) 게이트 유전체 스프링어 ISBN 1-4020-3077-0 재료 기초
- "금속 산화물 Si 트랜지스터의 고유전율 게이트 산화물" Robertson, J.(Prog의원). Phys.69 327-396 2006) 물리학 출판 doi:10.1088/0034-4885/69/2/R02 고유전율 게이트 산화물]
- 2007년 3월 인텔/IBM 언론 보도 BBC NEWS Technology Chips push through through nano-barrier, NY Times 기사 (2007년 1월 27일)
- Gusev, E.P. (Ed.) (2006) "고K 게이트 유전체 스택 결함: 나노 전자 반도체 소자", 스프링거 ISBN 1-4020-4366-X